半導體製程設備部件及其製作方法
專 利 證 書 號 數:I806656
名 稱:半導體製程設備部件及其製作方法
[1]申請專利範圍
- 一種適用於一半導體製程設備的部件,該部件包含:一基材,由矽所製成;及一保護塗層,覆蓋該基材的至少一部份;其中,該保護塗層中的碳原子比在遠離該基材的一方向上增加,且該保護塗層中的矽原子比在該方向上減少;及其中,在靠近該基材附近,該保護塗層中的矽原子比是大於碳原子比,且在靠近該保護塗層之一外表面附近,該保護塗層中的矽原子比是小於碳原子比。
- 如請求項1 所述的部件,其中,該基材附近的矽原子比是大於50%,且該保護塗層的外表面附近的碳原子比是大於50%。
- 如請求項1 所述的部件,其中,該保護塗層包括結晶矽,結晶矽具有(111)晶面、(220)晶面或前述晶面的一組合。
- 如請求項1 所述的部件,其中,該保護塗層包括經反應式物理氣相沉積所製成的3CSiC,且該3C-SiC 包括非晶碳化矽或具有(111)晶面的結晶碳化矽。
- 如請求項1 所述的部件,其中,該保護塗層的矽與碳的一相對含量比是2/3 至3/2。
- 如請求項1 所述的部件,其中,該保護塗層具有一第一部分及一第二部分,該第一部分是連接至該基材與該第二部分,且在該基材附近的矽原子比大於該第二部分的矽原子比。
- 如請求項6 所述的部件,其中,該保護塗層還具有一第三部分,該第三部分是連接至該第二部分並與該第一部分相對,該第三部分的碳原子比大於靠近該基材的第一部分的碳原子比。
- 如請求項1 所述的部件,其中,該保護塗層具有一介於0%至60%的結晶率。
- 如請求項1 所述的部件,其中,當一包括氣態SF6 和Cl2 的反應氣體在一反應離子蝕刻(RIE)模式的乾式蝕刻機中時,該保護塗層相對於該基材的一相對蝕刻速率是不大於3/5。
- 如請求項1 所述的部件,其中,該基材具有一表面,該表面包括複數微結構,各微結構具有一介於300nm 至1.5μm 間的高度,且該保護塗層具有一不小於10μm 的最小厚度。
- 如請求項1 所述的部件,其中,該保護塗層具有一不小於1.5μm 的最小厚度。
- 如請求項1 所述的部件,其中,該部件是一閉環物件。
- 如請求項12 所述的部件,其中,該閉環物件是一用於一乾式蝕刻設備中的聚焦環。
- 一種適用於一半導體製程設備的部件,該部件包含:一基材;及一保護塗層,覆蓋該基材的至少一部份;其中,該保護塗層包括經反應式物理氣相沉積所製成的3C-SiC,且該3C-SiC 包括非晶碳化矽或具有(111)晶面的結晶碳化矽,並且,該保護塗層包括結晶矽,結晶矽具有(111)晶面、(220)晶面或前述晶面的一組合。
- 如請求項14 所述的部件,其中,該保護塗層的矽與碳的一相對含量比是2/3 至3/2。
- 如請求項14 所述的部件,其中,該保護塗層具有一介於0%至60%的結晶率。
- 一種適用於一半導體製程設備的部件的製作方法,該方法包含:在一包括複數矽靶材與一基材的腔體內引入一惰性氣體;於該腔體內引入一包括碳元素的反應氣體;及電離化該惰性氣體成為電漿,使電漿撞擊該等矽靶材導致矽原子脫離該等矽靶材並與該反應氣體發生反應,從而形成一覆蓋該基材之至少一部分的碳化矽保護塗層。
- 如請求項17 所述的部件的製作方法,其中,該基材是由矽、氧化矽、石墨、陶瓷、金屬,或合金所製成。
- 如請求項17 所述的部件的製作方法,於引入該惰性氣體與該反應氣體前還包含在該腔體中放置偶數個矽靶材,該等矽靶材是佈置成至少一對彼此面對的矽靶材。
- 如請求項19 所述的部件的製作方法,還包含圍繞一虛擬中心軸旋轉該作為一閉環物件的基材。
- 如請求項17 所述的部件的製作方法,還包含:偏壓該基材,使該電漿的至少一部分離子撞擊該基材以移除該基材上的氧化層並於該基材的表面產生懸鍵;其中,該保護塗層是經由與懸鍵的化學鍵合形成在該基材上。
- 如請求項17 所述的部件的製作方法,還包含加熱或退火該基材至一低於碳化矽與該基材之熔點的溫度。
- 如請求項17 所述的部件的製作方法,其中,該惰性氣體的一流量、該反應氣體的一流量及用於電離化該惰性氣體的一射頻功率中的至少一者動態地變化,並且以一相比於該保護塗層形成過程中的初始數值的更大數值結束。
- 如請求項23 所述的部件的製作方法,其中,該惰性氣體的流量範圍自5slm 至24slm,該反應氣體的流量範圍自10sccm 至120sccm,且該射頻功率的範圍自0.4kW 至1.2kW。
- 如請求項17 所述的部件的製作方法,其中,形成該保護塗層的一速率是不小於6Å/sec。
-
本發明的其他的特徵及功效,將於參照圖式的實施方式中清楚地呈現,其中:圖1 是一流程圖,說明本發明之部件的製作方法的一些實施例,該部件是適用於被使用在一半導體製程設備中;圖2 是一示意圖,說明本發明一些實施例之用於執行該方法的一反應式物理氣相沉積設備;圖3 是一俯視示意圖,說明本發明一些實施例之該部件的一基材;圖4 是自圖3之直線IV-IV 所取得的一剖視圖;圖5 是一示意圖,顯示一保護塗層被形成於該基材上;圖6 至11 是示意圖,說明該保護塗層的不同變化;圖12 和13 顯示了該反應式物理氣相沉積設備的矽靶材的不同排列方式;圖14 是一放大示意圖,顯示該基材的複數微結構;圖15 是一放大示意圖,顯示該基材的微結構具有金字塔形的一變形例;圖16 是該部件之一具體例的一掃描式電子顯微鏡(scanning electron microscope;以下簡稱SEM)影像;圖17 顯示出圖16 所示之具體例的保護塗層的一能量色散X 射線光譜(energy-dispersive X-ray spectroscopy;以下簡稱EDS)分析結果;圖18 顯示出圖16 所示之具體例的保護塗層的一X 光繞射(x-raydiffraction;以下簡稱XRD)分析結果;圖19 是該部件的另一具體例的SEM 影像;圖20 顯示出圖19 所示之另一具體例的保護塗層的一EDS 分析結果;圖21 顯示出圖19 所示之另一具體例的保護塗層的一XRD分析結果;圖22 是該部件的再另一具體例的SEM 影像;圖23 顯示出圖22 所示之再另一具體例的保護塗層的一EDS 分析結果;圖24 顯示出圖22 所示之再另一具體例的保護塗層的一XRD 分析結果;圖25 至28 是SEM 影像,說明該基材的顯微影像及顯示於圖16、19 和22 在反應式離子蝕刻(reactive ion etching;以下簡稱RIE)程序後被蝕刻的顯微影像;及圖29 至34 顯示出高解析度穿透式電子顯微鏡(high resolution transmissionelectron microscope;簡稱HRTEM)影像及顯示於圖16、19 和22 之樣品的繞射圖案(diffractionpatterns)。

【圖1】
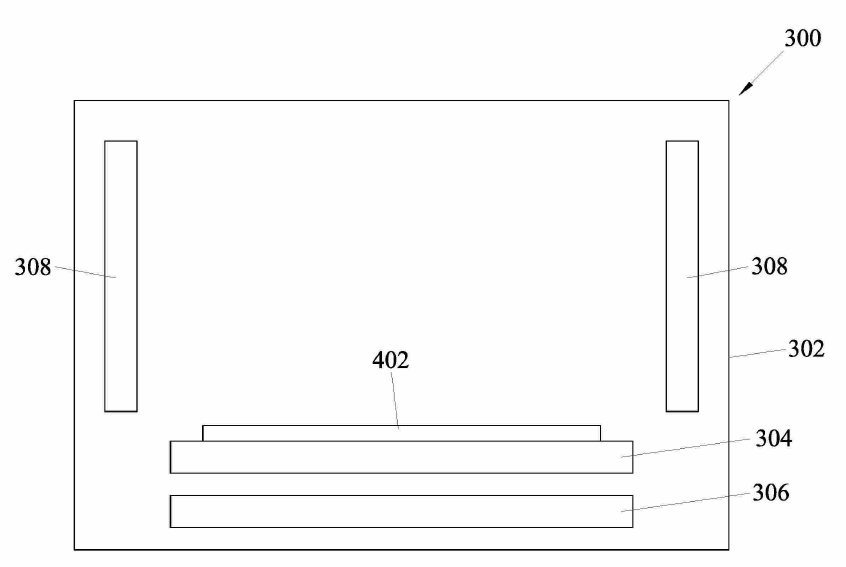
【圖2】

【圖3】

【圖4】

【圖5】
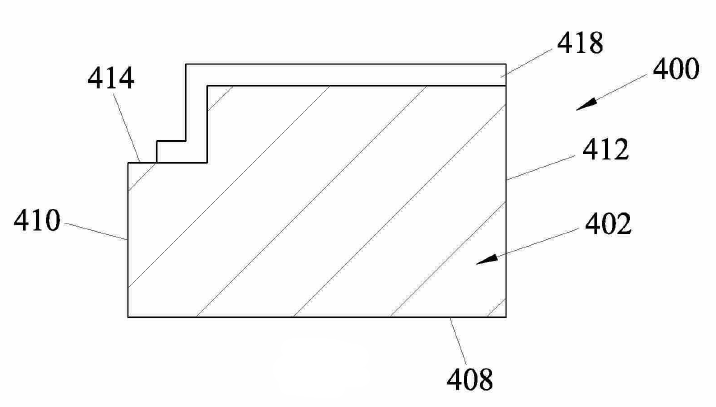
【圖6】
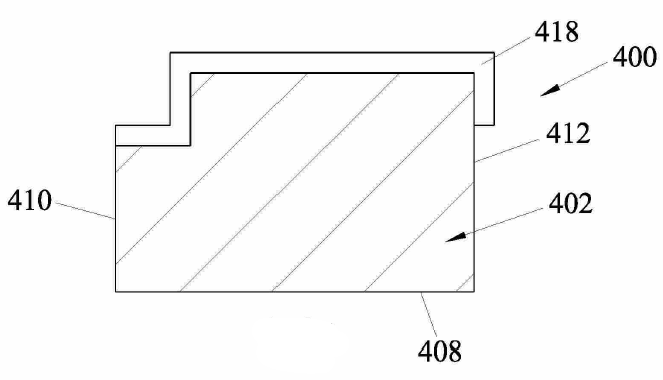
【圖7】
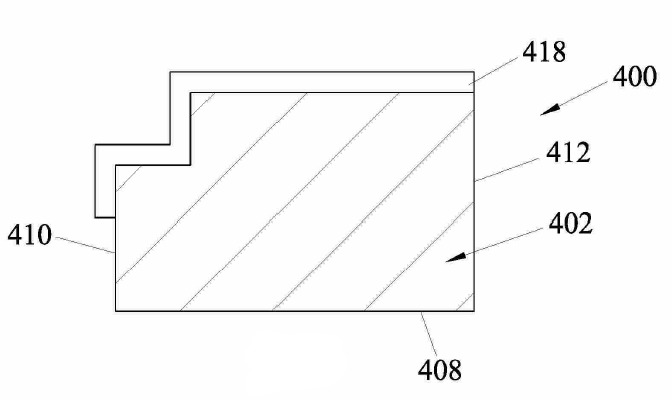
【圖8】
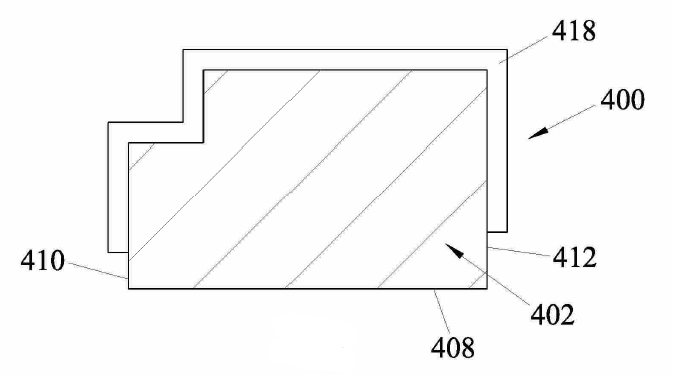
【圖9】
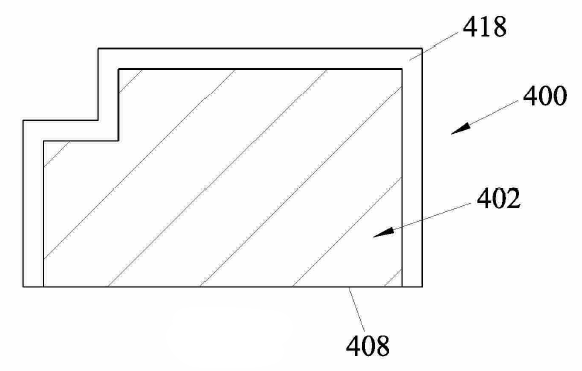
【圖10】
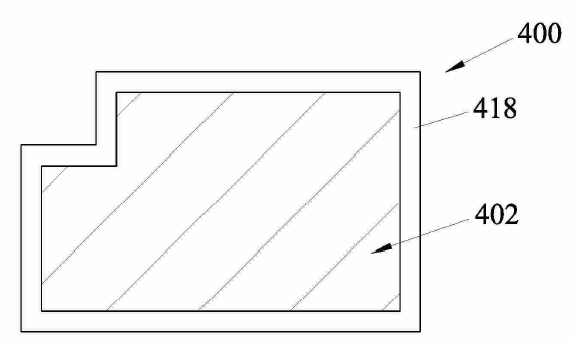
【圖11】

【圖12】

【圖13】

【圖14】

【圖15】
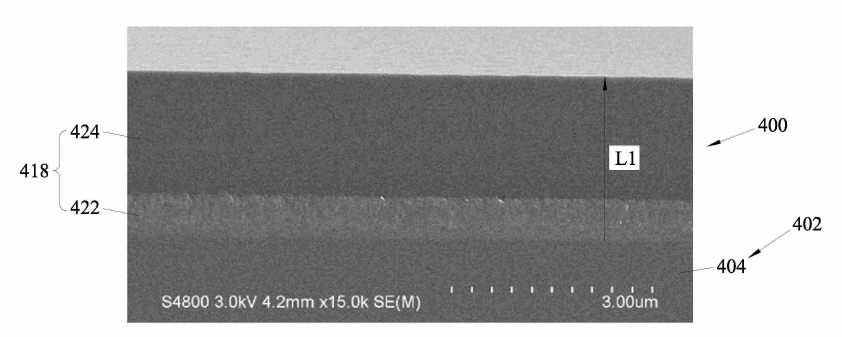
【圖16】

【圖17】
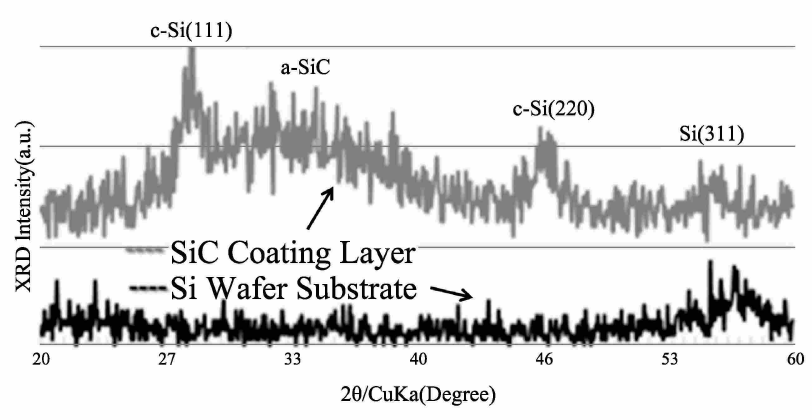
【圖18】
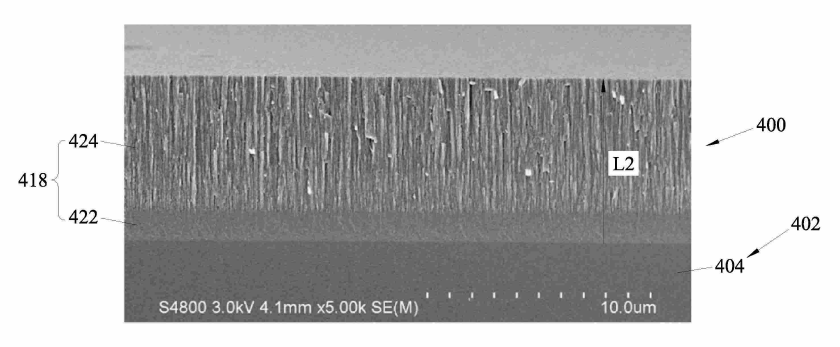
【圖19】

【圖20】
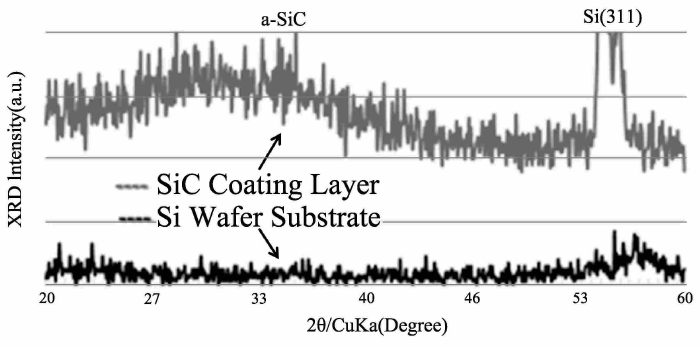
【圖21】
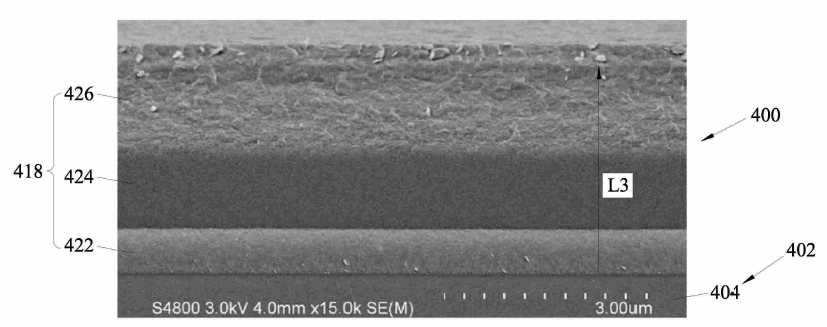
【圖22】

【圖23】
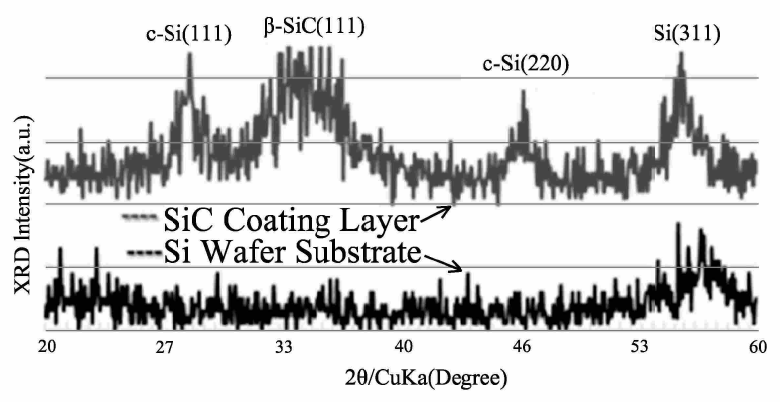
【圖24】
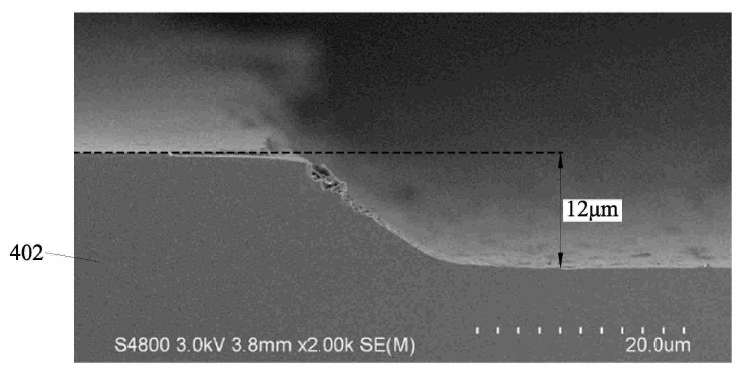
【圖25】
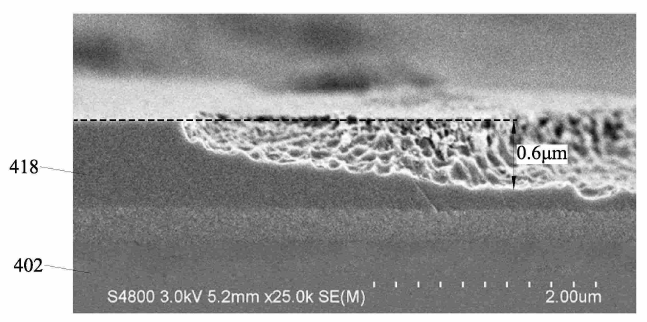
【圖26】
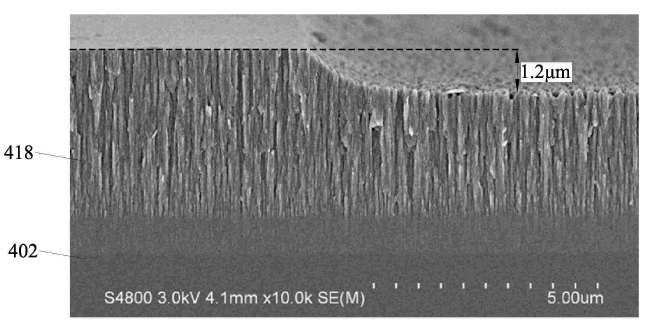
【圖27】
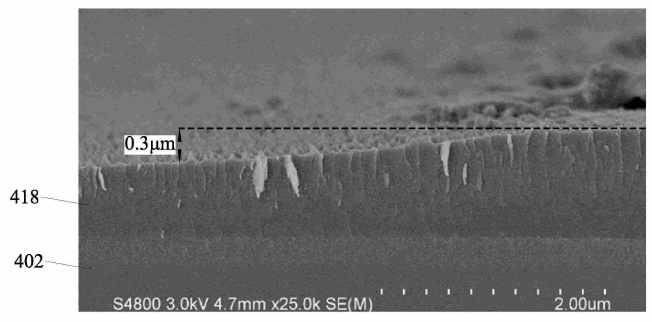
【圖28】
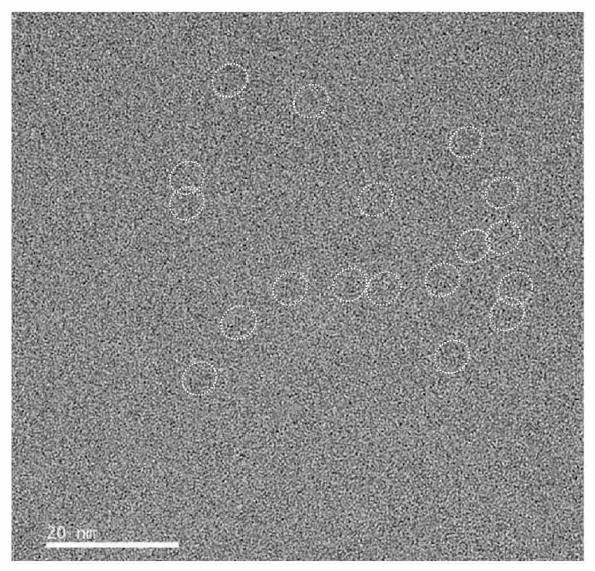
【圖29】

【圖30】

【圖31】

【圖32】
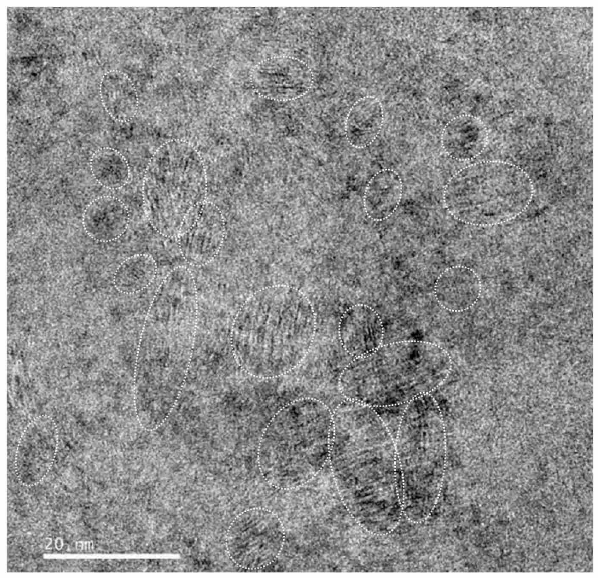
【圖33】

【圖34】
